光电半导体封装应用解决方案
Mini-LED封装SAC305合金解决方案: CB9000锡膏
产品介绍
CB9000 是一款专为小尺寸Mini-led封装设计的无铅免清洗锡膏。采用超细、窄粒度分布、高球形度、低氧含量锡粉,可满足长时间的印刷或针转移工艺需求。具有优异的操作性和焊接性能,焊点可靠性高、残留物低,可有效提高产品良率,和产品的亮度、寿命。
合金:Sn96.5/Ag3.0/Cu0.5
锡粉粒径(可选): T5/T6/T7
残留物:大约 3% (w/w)
包装尺寸:5CC/10g、10CC/30g针管装。

特性及优势
▶ 可适用微孔印刷工艺,以及高速粘胶工艺;
▶ 优异的脱模性,优异的粘胶均匀性;
▶ 优异的焊接可靠性;
▶ 更高的热导率与电导率;
▶ 焊后残留物极少,颜色透明,易清洗。
应用指南
CB9000系列锡膏可使用钢网印刷工艺或针转移工艺进行涂覆。
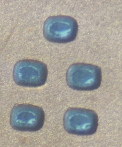 |  |
| 模性(开孔5mil×6mil) | 均匀的粘胶量 |
Mini-LED封装低温解决方案: LF143S-PF-T6锡膏
产品介绍
LF143S-PF-T6锡膏在实现低温焊接的同时,从根本上解决了NWO、HOP等焊接缺陷以及服役过程中焊点失效的问题,目前在消费电子、LED、通讯等领域获得了广泛应用。
合金:LF143S
合金熔点:141-143℃
锡粉粒径(可选): T6
残留物:大约 5% (w/w)
包装尺寸:5CC/10g、10CC/30g针管装。

※特别提示:LF143S-PF-T6锡膏同样适用于Micro-LED封装。
LED倒装芯片封装解决方案: LD650系列固晶锡膏
产品介绍
LD650系列锡膏是专为极小尺寸LED倒装芯片焊接设计的无铅焊膏,该产品具有优异的操作性、高焊点可靠性、低残留物等特点。满足倒装芯片固晶焊接的工艺需求。
合金:Sn96.5/Ag3.0/Cu0.5
锡粉粒径(可选): T7①
残留物:大约 3% (w/w)
包装尺寸:5CC/10g针管装
注①:针对250μm及以下尺寸的倒装芯片焊接,我们推荐T7合金粉末,该粉末属于超细粉(直径1-10μm),具有更好的涂覆填充性能,可满足微小焊点的焊锡量。

特性及优势
▶ 可适用微孔印刷工艺的下锡、脱模,以及超细针头的点涂工艺;
▶ 优异的焊接可靠性;
▶ 更高的热导率与电导率;
▶ 焊后残留物极少,颜色透明,易清洗。
应用指南
LD650系列锡膏可使用钢网印刷工艺或针筒点涂工艺进行涂覆。
 | 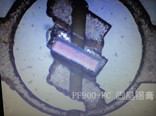 |
下一篇:IGBT功率模块封装解决方案


