LF143S系列新一代低温锡膏
背景介绍
首先,随着芯片软、小、轻、薄趋势化发展,常规焊料因温度过高而引起的 HOP 与 NWO 不良等焊接缺陷问题将会越来越突出;其次,在Intel推出新一代芯片的组装温度要求低于190℃,超温引起的不良率也变得不可接受;最后,以PET柔性板材为代表的新型柔性板材,组装温度高于200℃面临板材变形、起泡的问题。
基于以上行业痛点,开发一种高可靠性低温无铅焊料成为目前本领域急需解决的迫切问题。
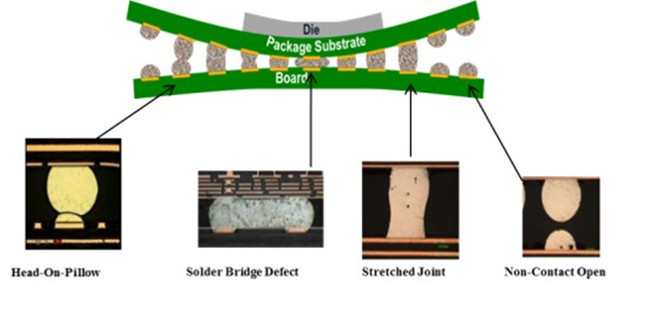
LF143S系列新一代低温锡膏
采用COMPO LF143S合金,颠覆传统通过添加微合金方式改善SnBi系合金可靠性的模式,通过合金体系的优化设计,研制出新型LF143S系列低温无铅锡膏,从根本上解决了传统Sn42Bi58可靠性差的问题,消除FCBGA(Flip Chip Ball Grid Array)焊接隐患。相比LTR(Low Temperature Reflow)锡膏焊接,无需改变现有工艺参数。优良的润湿性,适用于微型芯片,迷你散热铜管,手机信号线等行业,在满足焊接可靠性的同时,又降低了企业生产成本。
特性及优势
▶ 针对FCBGA,可有效降低BGA翘曲现象,消除高温对微小元器件的损伤,提高工作产量。
▶ 与LTR型锡膏相比,工艺参数无需改变,减少对设备以及工艺流程的改变。
▶ SMT应用锡膏:具备优良的细间距印刷能力,在 12 mil(0.30mm)圆形特征尺寸组件上也可实现高印刷下锡和低差异率;独特的配方设计,可有效防止立碑等;空洞率符合IPC Class III ,印刷后数小时仍保持良好的印刷性,基本无塌落,可操作寿命长;免清洗确保长期可靠性。
物理特性
序号 | 合金 | 粒度可选 | 合金熔点 |
1 | LF143S-PF | T4,T5,T6 | 141-143℃ |
2 | LF143-PF | T3,T4 | 141-143℃ |
应用领域
 |  |  |
| 笔记本电脑 | 移动终端 | LED显示/照明 |
 |  |
| 光伏组件 | 热敏元器件/柔性PCB |
上一篇:无
下一篇:无


